
生物学的応用向けナノプレッシャーセンサーの初期たわみ測定
この方法によって、取り外した薄膜のシーリング前とシーリング後のたわみを非破壊的な方法ですばやく測定できます
生物学応用向けナノプレッシャーセンサーの製造では、犠牲層エッチングと、ファブリ・ペロ共振器を形成するために真空で分離された2枚の薄膜のシーリングが極めて重要です。
また、加工後の薄膜の初期たわみ発生時期を正確に把握することも重要です。
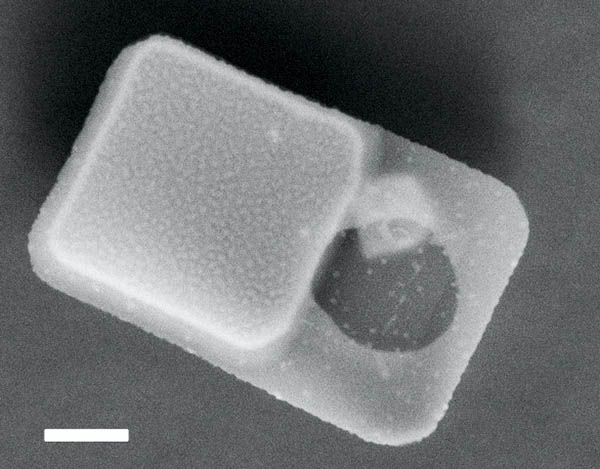
このプレッシャーセンサーは、真空ギャップで分離された2つのポリシリコン薄膜によって定義される機械式センサーと光学基準領域で構成される6×10 µmのチップです。
薄膜は平行反射鏡として機能し、一部の波長を部分的に透過するファブリ・ペロ共振器を形成します。 外部圧力Pによって薄膜のたわみが発生し、ギャップが変化します。このデバイスは、生細胞の異なる構成要素の内部の圧力変化を測定するために設計されたものです。
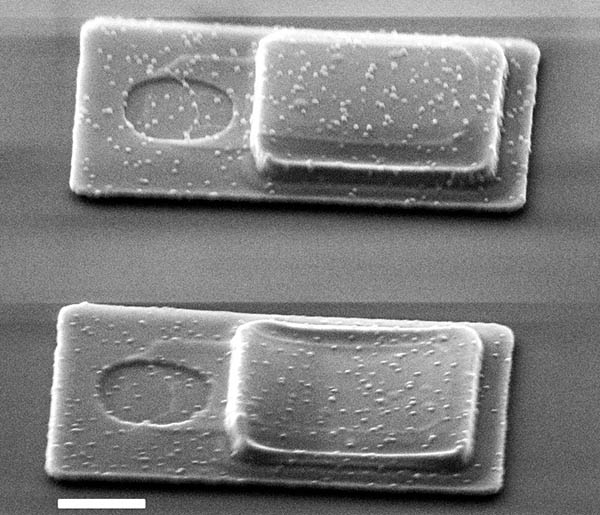
現在、薄膜のたわみは、組み込まれる前に走査型電子顕微鏡(SEM)で測定されていますが、SEMではサンプルに真空圧をかけておく必要があり、これによって初期の状態が変化する可能性があります。
Sensofarの光学式形状測定装置を使用し、製造後の薄膜のたわみを非破壊的な方法ですばやく測定することができました。チップの寸法はわずか数ミクロンですが、薄膜の湾曲は数十ナノメートル近くになるため、高倍率レンズを使用する必要があります。

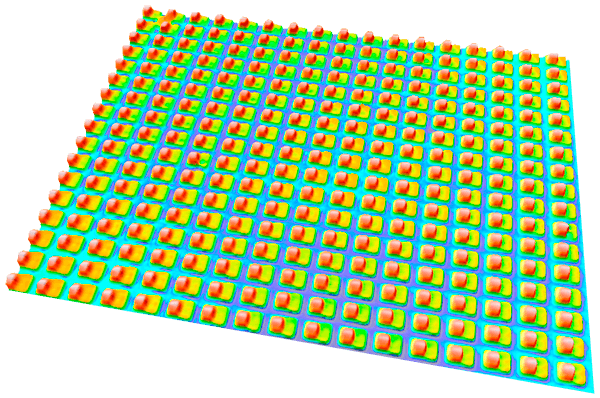
この方法によって、取り外した薄膜のシーリング前とシーリング後のたわみを非破壊的な方法ですばやく測定し、薄膜がつぶれているかどうかを確認することができます。これまでは、SEMで検査を実施する必要がありましたが、SEMでは真空圧によって薄膜のたわみが変化し、たわみの値の信頼性が得られませんでした。
これらの測定値は、Plµ 2300で共焦点法と100倍明視野対物レンズを使用して取得しました。 Sensofarの設備は、共焦点法、干渉法、焦点移動法に基づく非接触3D表面形状測定装置を提供します。Sensofarの設備では、高速かつ非破壊的な方法で高解像度測定が可能であり、また、使いやすいソフトウェアが必要に応じて技術的なサポートを提供します。













